
芯片封装技术主要包括:DIP双列直插式、组件封装式、PGA插针网格式、BGA球栅阵列式(PBGA基板、CBGA基板、FCBGA基板、TBGA基板、CDPBGA基板)、CSP封装(传统导线架形式、硬质内插板型、软质内插板型、晶圆尺寸封装)、MCM封装等。
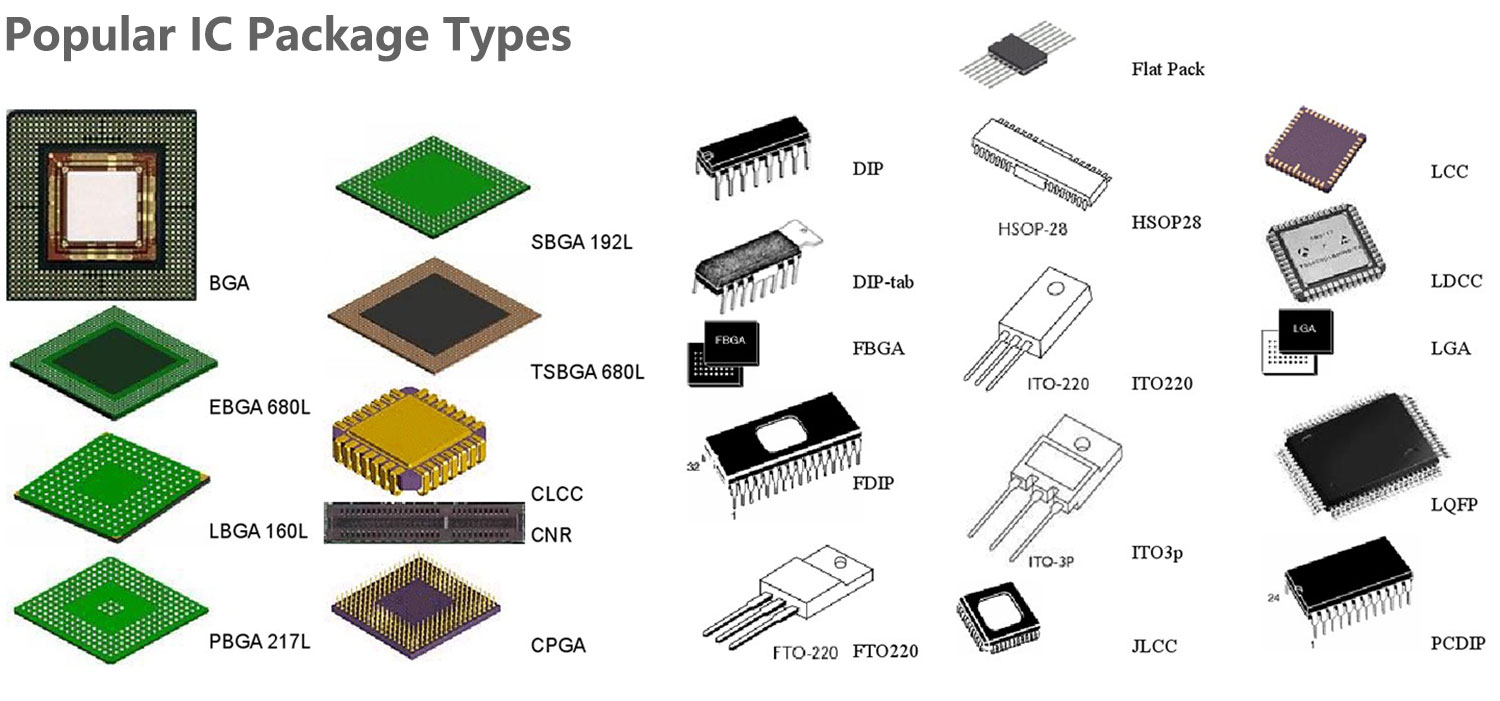
主流IC的封装类型
传统封装方式主要基于导线将晶片的接合焊盘与基板的引脚相连,实现电气联通,最后覆以外壳形成保护,主要方式有DIP、SOP、QFP等。
在芯片制程逐渐逼近硅片极限、摩尔定律推进速度放缓的行业趋势下,先进封装的出现优化了裸片间的连接方式,可以有效缩短异构集成架构下Die间信号距离,使得性能和功耗都得以优化。
目前业内半导体先进封装技术主要包括:SiP、WL-CSP、FC、eWLB、PiP、PoP及2.5D/3D封装技术等。
IC封装基板(IC Package Substrate)简称基板或载板,是连接并传递裸芯片(Die)与印刷电路板 (PCB)之间信号的载体,功能主要是保护电路、固定线路与散热。
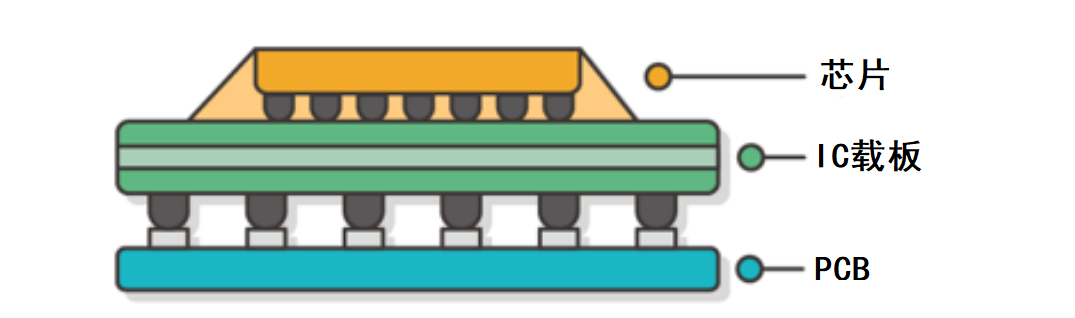
IC载板相比PCB具有更高的技术要求。IC载板由HDI技术发展而来,从普通PCB到HDI到SLP(类载板)到IC载板,加工精度逐步提升。IC载板目前有采用Tenting(PCB的减成法)工艺、SAP(半加成法)与MSAP(改良型半加成法)等工艺进行制造,所需设备有所不同,加工成本更高,线宽/线距、板厚、孔径等指标更为精细,同时对于耐热性要求也更高。
WB(Wire Bonding,打线)采用引线方式将裸芯片与载板连接,FC(Flip Chip,覆晶)将裸芯片正面翻覆,以锡球凸块直接连接载板,作为芯片与电路板间电性连接与传输的缓冲介面。
FC由于使用锡球替代引线,相比 WB 提高了载板信号密度,提升芯片性能,凸点对位校正方便,提高良率,是更为先进的连接方式。
 Wire Bonding 与 Flip Chip
Wire Bonding 与 Flip Chip
CSP适用移动端芯片尺寸小密度高,BGA适用PC/服务器级高性能处理器。
BGA(Ball Grid Array,球栅阵列封装)是在晶片底部以阵列的方式布置许多锡球,以锡球阵列替代传统金属导线架作为接脚。
CSP(Chip Scale Package,芯片级封装)可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,约为普通BGA的1/3,可理解为锡球间隔及直径更小的BGA。

BGA 与 CSP
从下游应用来看,FC-CSP多用于移动设备的AP、基带芯片,FC-BGA用于PC、服务器级CPU、GPU等高性能芯片封装,基板具有层数多、面积大、线路密度高、线宽线距小以及通孔、盲孔孔径小等特点,其加工难度远大于FC-CSP封装基板。
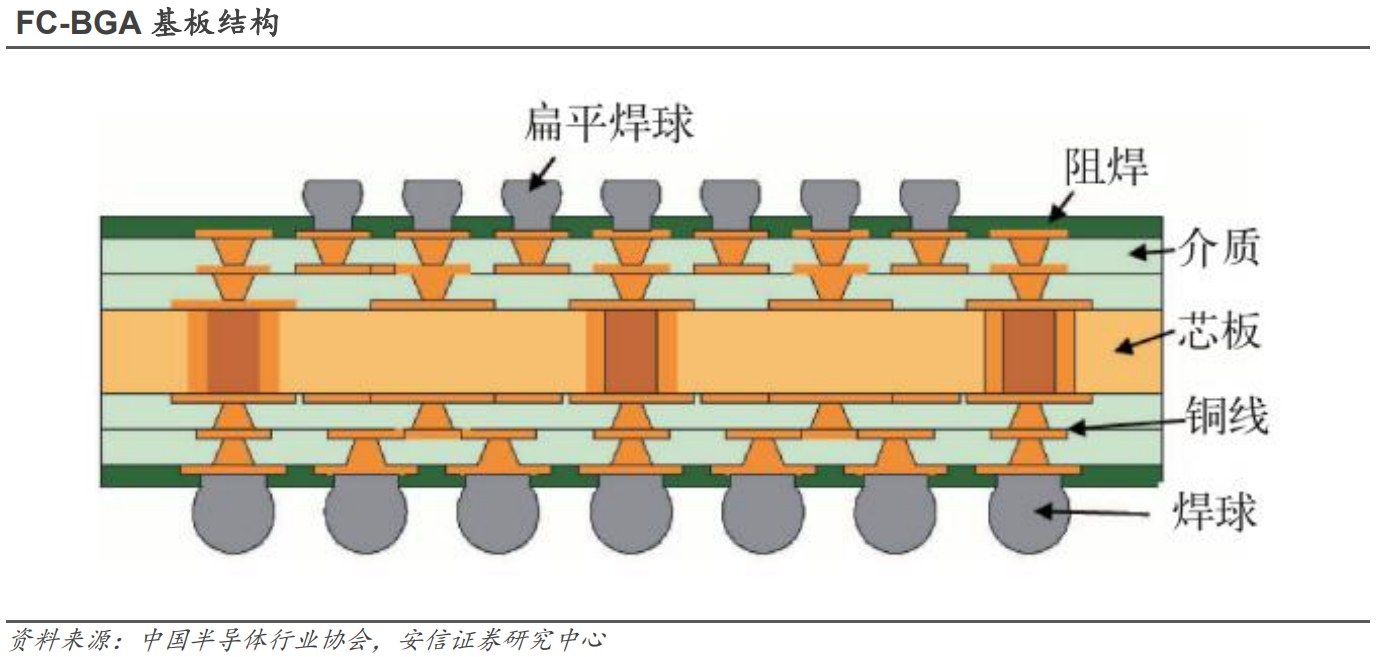
IC载板的基板类似PCB覆铜板,主要分为硬质基板、柔性薄膜基板和共烧陶瓷基板三大种类,其中硬质基板和柔性基板基本占据全部市场空间,这里我们主要就硬质基板展开。
BT基板是由三菱瓦斯研发的一种树脂材料,良好的耐热及电气性能使其替代了传统陶瓷基板,它不易热涨冷缩、尺寸稳定,材质硬、线路粗,主要用于手机 MEMS、通信及储存芯片封装。
ABF是由日本味之素研发的一种增层薄膜材料,硬度更高、厚度薄、绝缘性好,适用于细线路、高层数、多引脚、高信息传输的IC 封装,应用于高性能CPU、GPU等领域。
MIS是一种新型材料,与传统的基板不同, 包含一层或多层预包封结构,每一层都通过电镀铜来进行互连,线路更细、电性能更优、体积更小,在功率、模拟IC领域发展快速。
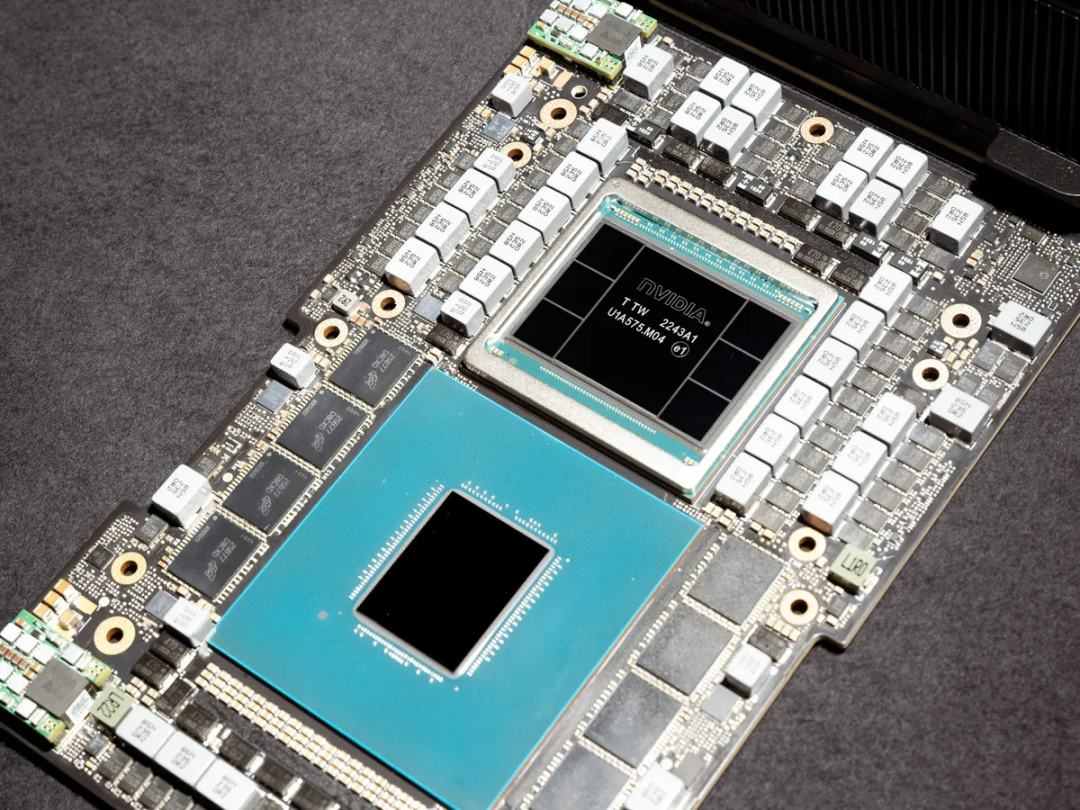
英伟达采用ABF载板的GH200
封装工艺的发展带动载板发展,FC工艺已成主流,多芯片3D封装、大尺寸高多层基板是当前发展方向。为提高性能、降低功耗、提高I/O,现阶段的单芯片封装将逐步向多芯片或整合性芯片封装发展,3D封装对于基板高密凸块及高刚性需求也是下代基板的发展方向。
5G时代对于电子产品和芯片高性能、小尺寸、低能耗的需求不断增长。根据半导体行业观察,5G手机接收高频波段依赖于复杂的射频前端和天线设计,通过先进封装技术,可以将天线埋入终端产品提升传输速度,并满足用户对于轻薄便携、传输快速、性能优良、能耗较低的需求。根据 Yole 数据,2026年全球 5G智能手机封装市场规模将达到 26 亿美元,CAGR 高达 31%。
ChatGPT 等大模型,参数庞大,训练和推理过程需要大量的算力芯片。数据中心AI加速器的潜在市场总额将从今年的300亿美元增长到2027年的1500亿美元以上。AI 芯片主要包括GPU、CPU、FPGA和ASIC。
后摩尔时代,经济效能的提升出现瓶颈,先进封装在在提高芯片集成度、电气连接以及性能优化的过程中的重要性逐渐凸显,Chiplet(“芯粒”)技术应运而生。
Chiplet将一类满足特定功能的Die(裸片),通过内部互联技术实现多个模块芯片与底层基础芯片封装在一起,形成一个系统芯片。它可以将不同制程的芯片封装到一起达到系统化最优性能,可以提高芯片良率、降低设计复杂度与成本、降低制造成本。
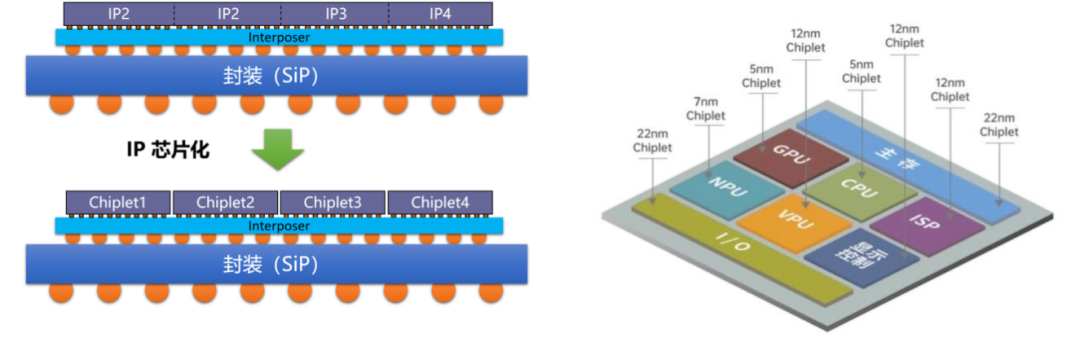
Chiplet封装工艺
根据Omdia的统计数据,2024年,采用 Chiplet 的处理器芯片的全球市场规模将达58亿美元,到2035年将达到570亿美元,年复合增长率约为23.09%,同时Chiplet处理器芯片市场规模的快速增长将带动ABF载板需求量的提升。